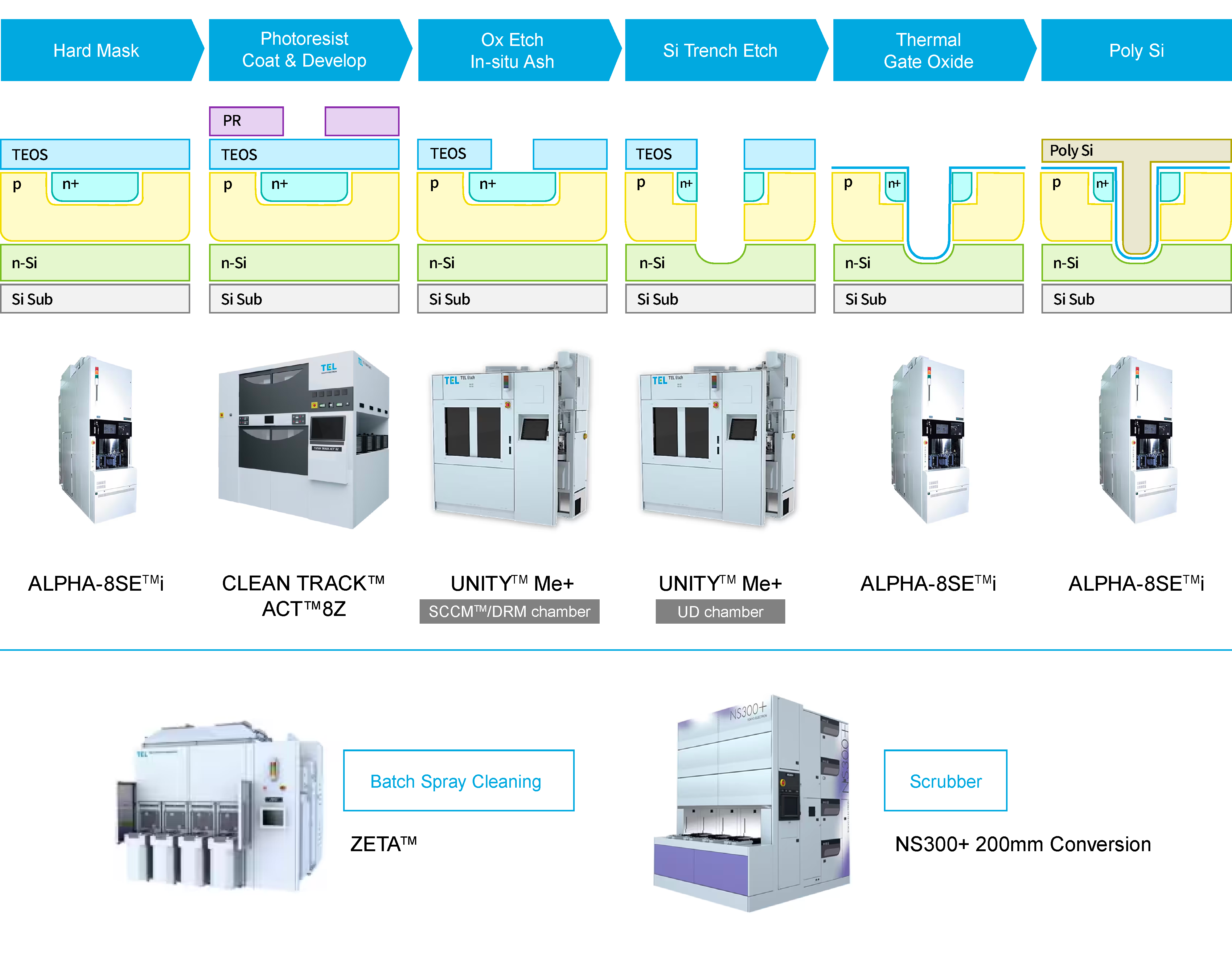
Hard Mask

ALPHA-8SE™i
200mm 이하 웨이퍼 대응 배치식 열처리 성막(Batch thermal processing)장비. 장비를 안정적이고 지속적으로 가동하기 위해 조작성·기능성을 향상시켰으며 세계적인 안전 기준에도 적합.

Photoresist Coat & Develop

CLEAN TRACK™ ACT™8Z
75~200mm 웨이퍼에 대응하는 도포 현상(Coater/developer) 장비는 다양한 기판(Si, GaAs, GaN, SiC, Thin & Thick 등)에 대응 가능. SOD 도포 성막에도 대응 가능.
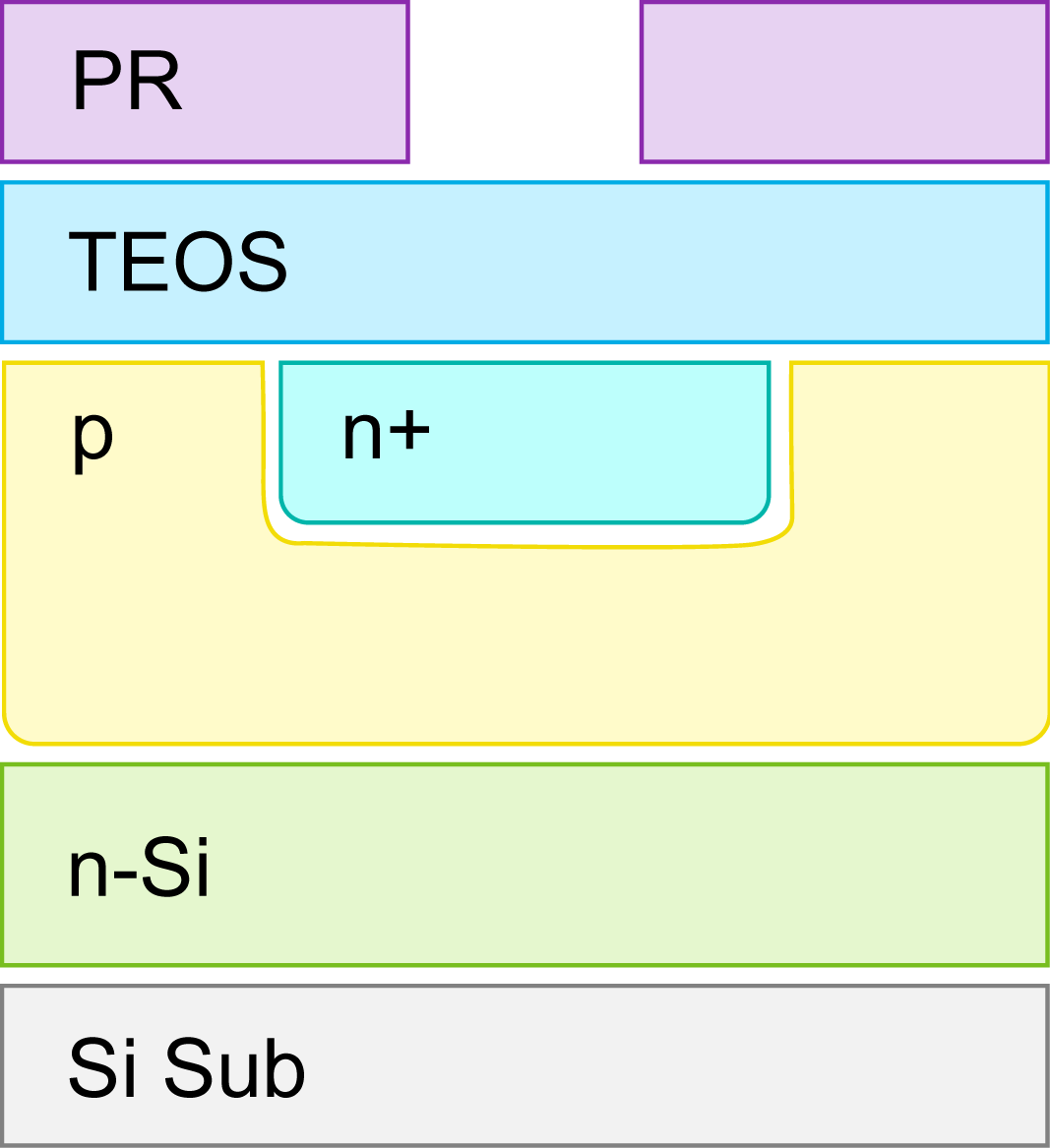
Ox Etch In-situ Ash

UNITY™ Me+ / DRM chamber
100~200mm 웨이퍼 대응 플라스마 에칭 (Plasma etch system) 장비. 양산 라인에서 높은 가성비를 구현하여 우수한 생산성과 높은 신뢰성을 달성.
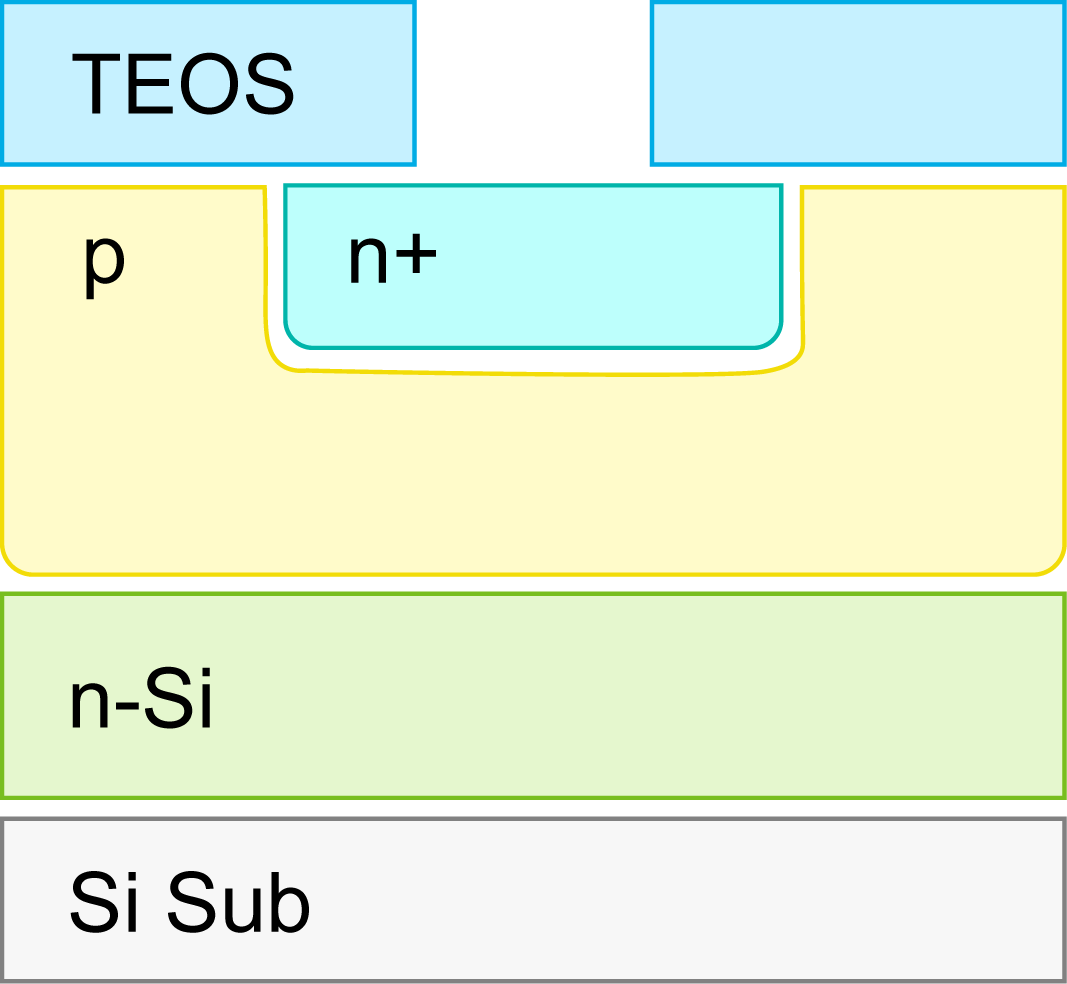
Si Trench Etch

UNITY™ Me+ / UD chamber
100~200mm 웨이퍼 대응 플라스마 에칭 (Plasma etch system) 장비. 양산 라인에서 높은 가성비를 구현하여 우수한 생산성과 높은 신뢰성을 달성.
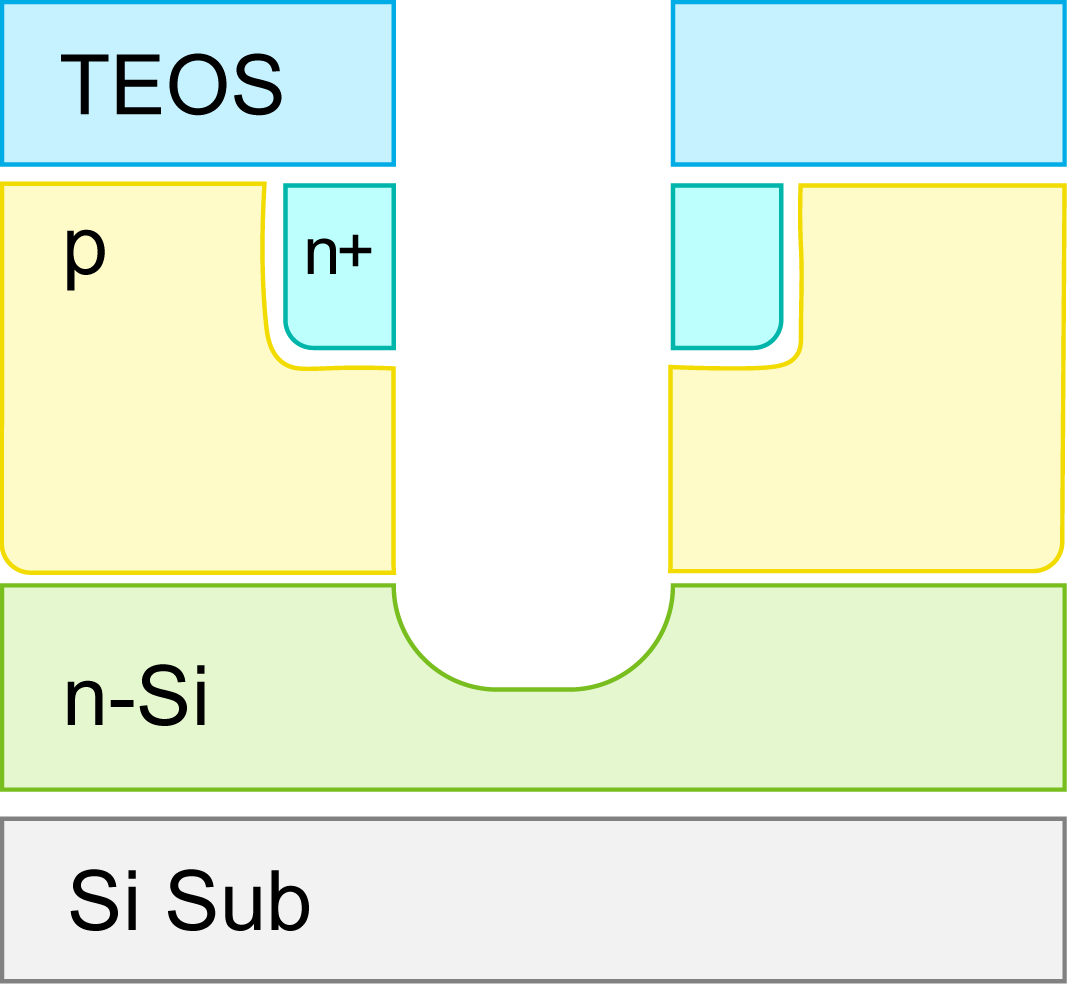
Thermal Gate Oxide

ALPHA-8SE™i
200mm 이하 웨이퍼 대응 배치식 열처리 성막(Batch thermal processing)장비. 장비를 안정적이고 지속적으로 가동하기 위해 조작성·기능성을 향상시켰으며 세계적인 안전 기준에도 적합.
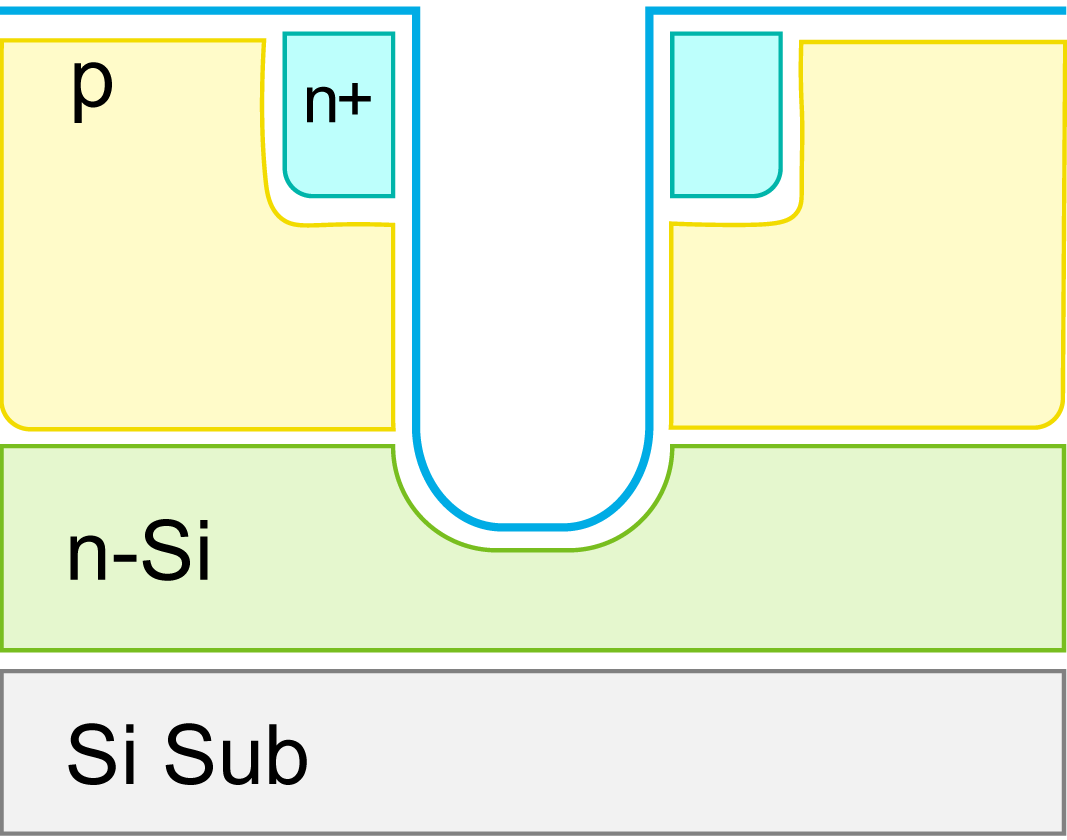
Poly Si

ALPHA-8SE™i
200mm 이하 웨이퍼 대응 배치식 열처리 성막(Batch thermal processing)장비. 장비를 안정적이고 지속적으로 가동하기 위해 조작성·기능성을 향상시켰으며 세계적인 안전 기준에도 적합.
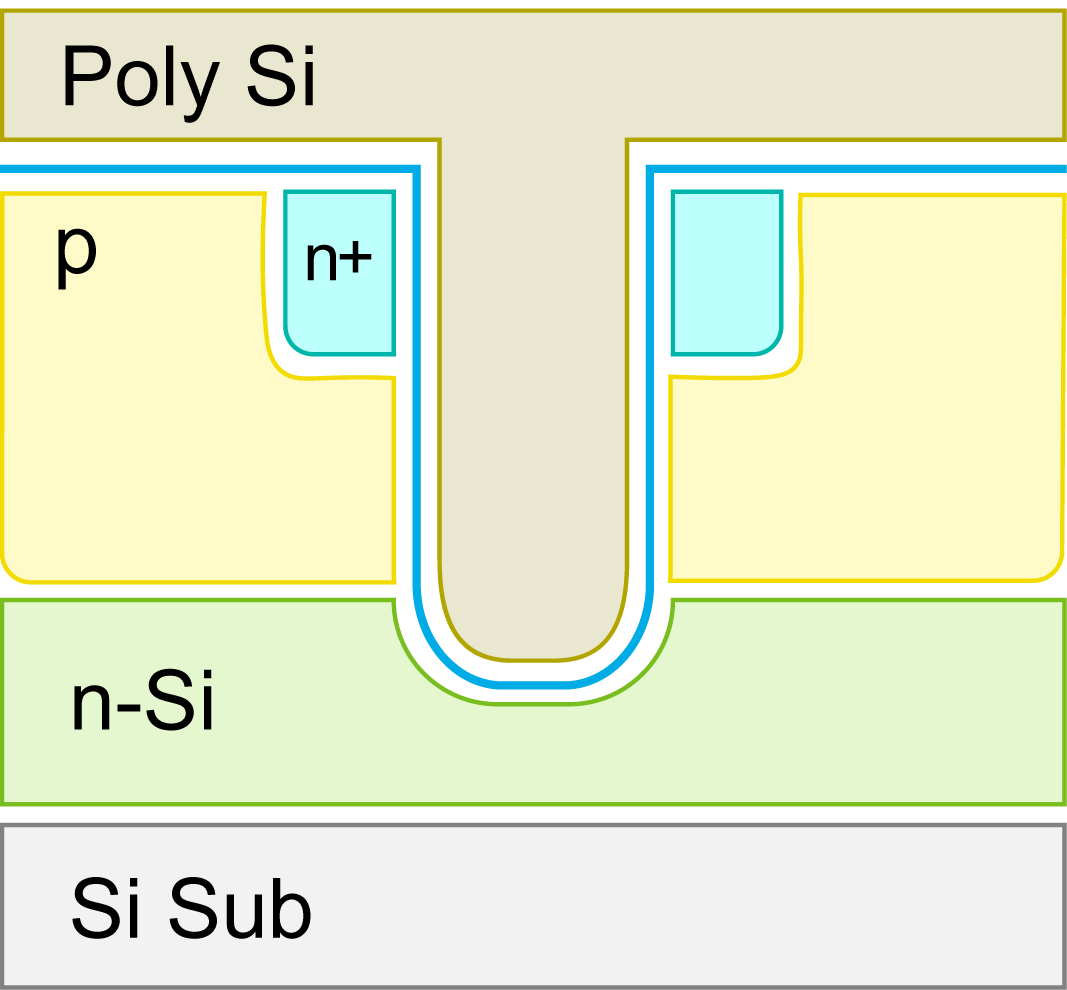
Batch Spray Cleaning

ZETA™+
300/200mm 웨이퍼 대응 전자동 배치 스프레이 세정(Batch spray cleaning) 장비. 최적의 반송 청정도 환경을 제공하는 국소 환경(Mini-environment) 시스템을 장착한 FOUP/SMIF에 대응, 저비용의 세미 오토 사양도 가능.
Scrubber

NS300+ 200mm Conversion
200mm/150mm 웨이퍼 대응 스크러버 세정(Water scrubber) 장비. 300mm 차세대 디바이스용 세정 프로세스 기술을 탑재해 높은 신뢰성과 생산성을 실현.
